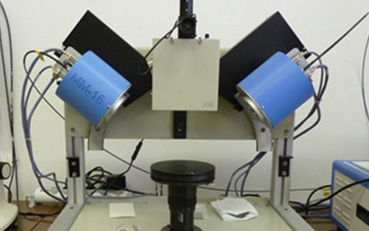
Jedna z najkomplexnejších meracích metód, ktorou možno merať hrúbky tenkých vrstiev, ale aj ich fyzikálne vlastnosti je spektroskopická elipsometria. Dokáže analyzovať anorganické aj organické vrstvy od jedného nanometra až po desiatky mikrometrov. Takéto štruktúry predstavujú základ technológie výroby mikro a nanoelektronických súčiastok. Aj keď je elipsometria pomerne stará metóda, postupne sa buduje od konca 19. storočia, má nenahraditeľné miesto vďaka neinváznemu charakteru, meraniu bez potreby referenčnej vzorky, ale najmä vďaka účinným metódam spracovania experimentálnych dát a vyhodnotenia množstva fyzikálnych parametrov materiálov.
V článku v časopise Optik sme analyzovali nesúvislú vrstvu gáliovo nitridových nanodrôtikov. Navrhli sme elipsometrický model takejto štruktúry a porovnali sme ho so záznamami zo skenovacieho elektrónového mikroskopu. Správne navrhnutý model možno neskôr použiť pri optimalizácii výroby podobných nanoštruktúr.
Viac v článku: